作为突破最大可制造芯片尺寸界限的努力的一部分,台积电正在研究其新的 Chip-On-Wafer-On-Substrate-L (CoWoS-L) 封装技术, 该技术将使其能够构建更大的超级载体中介层。针对 2025 年的时间跨度,下一代 TSMC 的 CoWoS 技术将使中介层达到 TSMC 最大reticle的六倍,高于其当前中介层的 3.3 倍。这种强大的系统级封装 (SiP) 旨在供对性能要求很高的数据中心和 HPC 芯片使用,事实证明,这个利基市场愿意支付高额溢价,以便能够在单个封装上放置多个高性能小芯片。
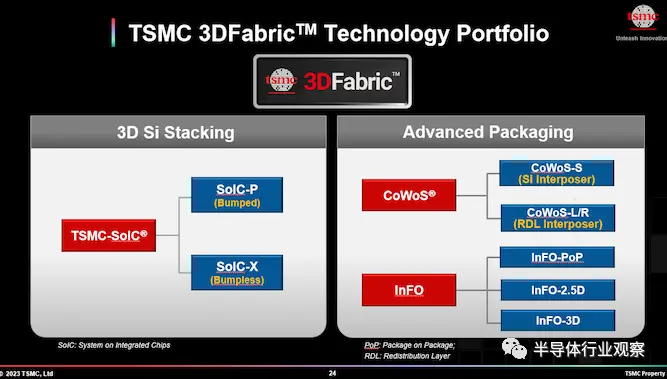
“我们目前正在开发采用 Super Carrier 中介层技术的 6 倍光罩尺寸的 CoWoS-L 技术,”负责代工厂高性能计算业务部门的台积电业务发展总监 Yujun Li 在公司 2023 年欧洲技术研讨会上说。.
人工智能 (AI) 和高性能计算 (HPC) 等全球大趋势创造了对看似无限的计算能力的需求,这就是为什么像 AMD、英特尔和 NVIDIA 这样的公司正在构建极其复杂的处理器来处理这些 AI 和 HPC 应用程序. 提高处理器计算能力的方法之一是增加晶体管数量。如今,为了高效地做到这一点,公司使用了多块小芯片设计。英特尔令人印象深刻的 47 tiles Ponte Vecchio GPU 就是此类设计的一个很好的例子;但台积电的 CoWoS-L 封装技术将使代工厂能够为更庞大的处理器制造超级载体中介层。

理论上的 EUV reticle限制为 858mm²(26 毫米 x 33 毫米),因此这些掩模中的六个将实现 5148 毫米2的 SiP 。如此大的中介层不仅可以为多个大型计算小芯片提供空间,还可以为 12 堆栈HBM3 (或 HBM4)内存留出足够的空间,这意味着 12288 位内存接口带宽高达 9.8 TB/秒。
“Super Carrier 中介层在中介层的正面和背面具有多个 RDL 层,以提高良率和可制造性,”Li 解释道。“我们还可以在解释器中集成各种无源组件以提高性能。这种六reticle大小的 CoWoS-L 将于 2025 年验证”
构建 5148 mm² SiP 是一项极其艰巨的任务,我们只能想知道它们将花费多少以及它们的开发人员将为此收取多少费用。目前 NVIDIA 的 H100 加速器,其封装跨越一个中介层多个光罩大小,成本约为 30,000 美元。因此,更大、更强大的芯片可能会进一步推高价格。

但是支付大型处理器的成本并不是数据中心运营商需要进行的唯一巨额投资。5148 mm 2 SiP 可以容纳的活性硅数量几乎肯定会导致生产一些迄今为止最耗电的 HPC 芯片——这些芯片也需要同样强大的液体冷却来匹配。为此,台积电透露,它一直在测试片上液体冷却技术,并表示它已经设法冷却功率水平高达 2.6 kW 的硅封装。因此,台积电确实有一些想法来处理这些极端芯片的冷却需求,即使只是以集成更多尖端技术为代价。
01 台积电的最强武器
说到AI伺服器的能耗问题,不少半导体业者的直觉反应,就是靠摩尔定律解决不就好了?例如,台积刚量产的3纳米制程,能耗可以较前一代5纳米降三成到三成五。但有趣的是,英伟达最新、最高阶的GPU都不是当下台积的最先进制程。
「已经好几代都是这样,」一位资深半导体分析师也观察到这现象。
「黄仁勋算盘打得很精,」该分析师说,主要是近年先进制程愈来愈贵,得到的效能提升却愈来愈小,英伟达宁可等个两年,待制程良率稳定、价格下跌再进场,并选择将资源投在软体优化、新架构上,「效果可能好上10倍,可说是本小利多,」该分析师坦言。
英伟达能如此好整以暇,一大原因也是其寡占AI市场,没有导入昂贵新制程的迫切理由。这对于台积的未来可能是个警讯。
首先,去年台积高速运算业务占营收比重达41%,首度超越智能型手机的39%。

业界都将之视为典范转移。智能型手机市场已成熟,以AI为首的高速运算,将成为未来台积的成长火车头。
但英伟达对最先进制程的不积极态度,让上述说法,显得有点一厢情愿。
然而,一位英伟达供应商高层告诉《天下》,英伟达GPU之一H100的技术重点,其实是在旁边整颗用台积的CoWoS技术,与6颗昂贵的第三代高频记忆体(HBM3)连接起来的架构,每一颗记忆体可扩充到80GB、每秒3TB的超高速资料传输,让美国科技媒体惊呼「怪物」。
这是「后摩尔时代」的技术特征。英伟达竞争者超微的MI300,也有类似架构。与此同时,据台湾《电子时报》,近期业界传出,微软正在接触台积电供应链及旗下设计公司,希望将台积电代工厂的CoWoS封装技术用于其自研AI芯片。
02 台积电CoWoS:10年进化5代的封装技术
正如之前所说,台积电根据中介层(interposer)的不同,将其“CoWoS”封装技术分为三种类型。一种是“CoWoS_S(Silicon Interposer)”,它使用硅(Si)衬底作为中介层。这种类型是2011年开发的第一个“CoWoS”技术,在过去,“CoWoS”是指以硅基板作为中介层的先进封装技术。
另一种是“CoWoS_R(RDL Interposer)”,它使用重新布线层(RDL)作为中介层。
第三个是“CoWoS_L(Local Silicon Interconnect and RDL Interposer)”,它使用小芯片(chiplet)和RDL作为中介层。请注意,“本地硅互连”通常被台积电缩写为“LSI”。
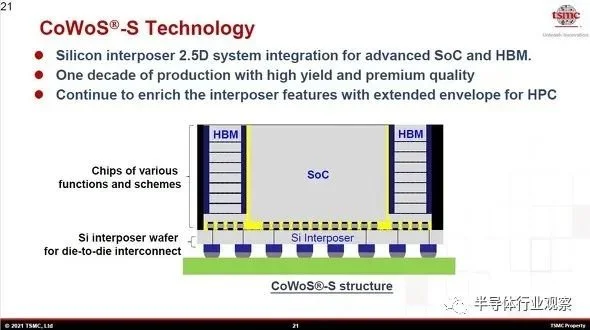
“CoWoS_S”(传统的“CoWoS”)的横截面结构示例。是所谓2.5D封装的代表。通过在作为中介层的硅基板上形成高密度布线和硅通孔(TSV),可以在硅芯片之间紧密放置并传输高速信号
03 继续扩大中介层面积、晶体管数量和内存容量
“CoWoS_S”(原“CoWoS”)于2011年开发。这被称为“第一代(Gen-1)”CoWoS封装技术首先是被 Xilinx 的高端 FPGA 采用。其中,Si 中介层的最大尺寸为775mm 2 (25 mm x 31 mm)。它接近一个掩模版的曝光尺寸(26mm x 33mm)(在 ArF 浸入式光刻机的情况下)。FPGA 芯片制造技术是 28 纳米 CMOS 工艺。采用该技术的赛灵思高端FPGA“7V2000T”在“CoWoS_S”中配备了四个FPGA逻辑芯片。
在2014年开发的第二代“CoWoS_S”中,硅中介层扩大到1150mm2。接近1287mm2,这是1.5分划板的曝光面积。2015年被赛灵思高端FPGA“XCVU440”采用。它配备了三个 FPGA 逻辑芯片。FPGA 芯片制造技术是 20 纳米 CMOS 工艺。
在2016年开发的第三代“CoWoS_S”中,虽然Si中介层的尺寸没有太大变化,但高速DRAM模块“HBM”和逻辑首次混合使用。2016年率先被NVIDIA的高端GPU“GP100”采用。在这种封装下,GPU 芯片和“HBM2”混合在一起。HBM2 是硅片叠层模块(4 个 DRAM 芯片和 1 个基片(底部)通过 TSV 连接),“GP100”配备了 4 个16GB(128Gbit的HBM2 模块和大容量的DRAM和GPU高速连接。
在 2019 年开发的第4代“CoWoS_S”中,Si 中介层的尺寸已扩大到相当于两个光罩的曝光面积——大约1700 mm 2。这个巨大的中介层装有一个大型逻辑芯片和 6 个 HBM2。由于一个HBM2存储的容量增加到8GB(64Gbit),所以总容量为48GB(384Gbit),是第三代容量的3倍。
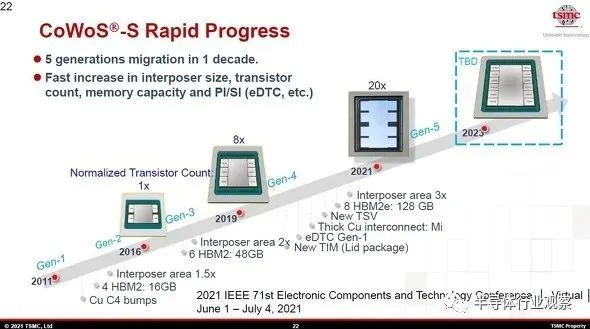
“CoWoS_S”(传统的“CoWoS”)的演变。2011年第1代到2021年第5代的改进。
04 要集成的逻辑和内存总是很大
在上文中我们谈到,高性能封装技术“CoWoS(Chip on Wafer on Substrate)”从首次开发起约10年的时间内推出了多款衍生产品。接下来,让我们还回顾一下“CoWoS”技术自 2011 年首次开发以来的发展历程。
最初的“CoWoS”技术使用硅(Si)衬底作为中间衬底(中介层)。目前,台积电称这种类型为“CoWoS_S(Silicon Interposer)”。正如第一部分所解释的,从2011年的第一代到2019年的第四代,CoWoS技术不断扩大中介层面积、晶体管数量和内存容量。
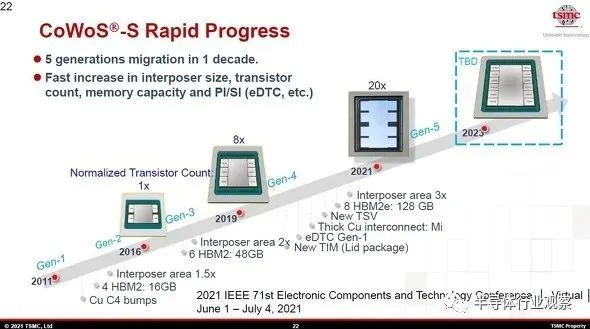
注:“CoWoS_S”(传统的“CoWoS”)的演变。从2011年的第一代升级到2021年的第五代。2023年研发下一代“CoWoS_S”
中介层原本很大,但现在变得更大了。第一代的面积相当于一个标线(775mm2),第二代和第三代的面积相当于1.5个标线(1150mm2和1170mm2)。在第 4 代中,它变得更大,达到了相当于两个标线 (1700mm2 ) 的面积。
最初,安装在中介层上的硅芯片是多个逻辑芯片。从第3代开始,它支持逻辑和内存的混合加载。它现在配备了一个逻辑 (SoC) 芯片和一组高速DRAM模块“HBM(高带宽内存)”的层压芯片。具体来说,将一个SoC芯片和四个 HBM(4GBx4,总共16GB)安装在一起。到了第4代,SoC die的面积(集成规模)扩大了,要混合的 HBM 数量增加到了6个。通过将一个 HBM 的存储容量增加一倍,HBM 的总容量已显著增加到第三代的三倍(48GB)。
05 “CoWoS_S”的改进助推HPC系统演进
台积电在今年(2021年)开发的第5代“CoWoS_S”将Si中介层进一步扩大到2500mm2,这相当于3个光罩,是第3代的两倍大,安装了8个HBM。Logic 的硅芯片再次成为小芯片,在总面积为1200mm2 的地方放置了两个迷你芯片。可安装的 HBM 规格为“HBM2E”(HBM 2nd generation 的增强版)。
通过使铜 (Cu) 布线比以前更厚,Si 中介层的重新布线层 (RDL) 将薄层电阻降低到不到一半。用 5 层铜线连接硅芯片。台积电还重新设计了 TSV,以减少由于硅穿透孔 (TSV) 引起的高频损耗。重新设计后,2GHz至14GHz高频范围内的插入损耗(S21)从传统的0.1dB以上降低到0.05dB以上。此外,通过将具有深槽的高容量电容器“eDTC(嵌入式深沟槽电容器)”装入 Si 中介层,台积电进一步稳定了电源系统。eDTC 的电容密度为 300nF/mm2。在100MHz至2GHz的频率范围内,配电网络 (PDN) 的阻抗已通过eDTC降低到35%以下。

06 支持第5代“CoWoS_S”(传统“CoWoS”)的基本技术
下一代(第6代)“CoWoS_S”计划于2023年开发。Si中介层的尺寸更大,有四个掩模版。通过简单的计算,它达到约3400mm2 (约58.6mm见方)。逻辑部分配备了两个或更多带有小芯片的迷你芯片,内存部分配备了12个HBM。相应的HBM规范似乎是“HBM3”。
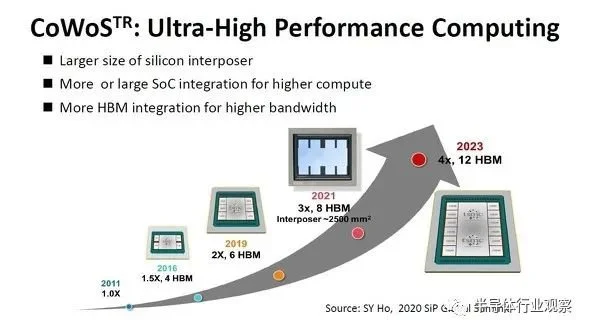
“CoWoS_S”发展路线图
07 硅中介层将处理器处理性能提升 2.5 倍
高性能计算(HPC)的封装技术“CoWoS(Chip on Wafer on Substrate)”首次出现在10年前(2011年)。正如前文所说,在过去十年里,我们不断扩大集成规模,提升每一代的性能,并为“CoWoS”开发了衍生产品,目前主流产品的名称已更改为“CoWoS_S”。“_S”表示将硅(Si)基板用于中间基板(中介层)。
除了高密度连接之外,硅中介层在缓解封装基板(树脂基板)和硅芯片(逻辑芯片、存储器芯片等)之间发生的热变形方面也扮演着重要的角色。因为热失真会导致电路操作延迟。
在一个活动上,台积电展示了倒装芯片连接封装和 CoWoS 封装与7nm代 CMOS 逻辑的 CPI(每条指令的时钟数)的比较结果。如果在倒装芯片连接到封装板(树脂板)的700 mm 2 SoC(片上系统)芯片上将 CPI 设置为“1”,则采用 CoWoS_S 技术封装的 840mm2 SoC 芯片的 CPI短至“0.4”。成为。这意味着指令处理性能提高了 2.5 倍。
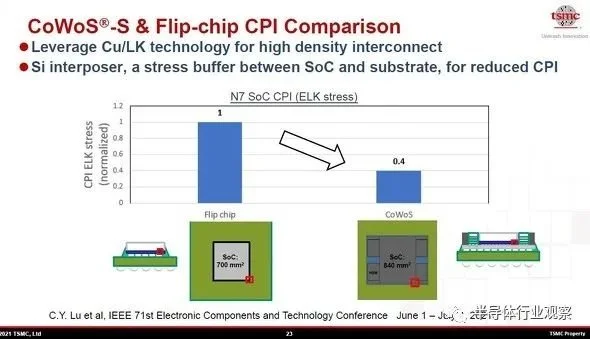
注:将CPI(每条指令的时钟数)与“CoWoS_S”和倒装芯片进行比较。由于Si中介层减轻了热变形,“CoWoS_S”的CPI(相对值)为0.4,比倒装芯片的CPI短。如果时钟频率相同,指令处理性能将提高2.5倍
08 混合宽带存储器“HBM”和SoC的“CoWoS_S”的标准化配置和布局
“CoWoS_S”的特点是混合了宽带内存模块“HBM(High Bandwidth Memory)”和大规模SoC的高性能子系统。通过Si中介层连接HBM和SoC,实现了宽带内存访问。
“HBM”的规格对于每一代都有共同的标准。产品的传播始于第二代“HBM2”。下一代是HBM2的增强版“HBM2E”。下一代是“HBM3”,容量越来越大,带宽越来越宽。
此外,“CoWoS_S”中安装的HBM数量将增加,Si中介层面积将增加,SoC制造技术将小型化。SoC 的形式将从单芯片变为小芯片,再到SoIC(集成芯片系统)。构成“CoWoS_S”的元素技术将会增加并变得更加复杂。

宽带内存模组“HBM”(横轴)的演进以及对应“CoWoS_S”(纵轴)的功耗、速度、内存带的转变
因此,台积电提供具有标准化配置和布局的“CoWoS_S STAR(标准架构)”,以便作为客户的半导体供应商可以快速开发采用“CoWoS_S”的子系统。可使用对应于 HBM2 的“STAR 1.0”和对应于 HBM2E 的“STAR 2.0”。

将SoC和HBM混合的“CoWoS_S”的配置标准化的“CoWoS_S STAR”概述
标准化的是硅中介层的最大尺寸、HBM 的数量和硅芯片的布局。客户可以从三种基本规格中进行选择:最大配置、中间配置和最小配置。
最大配置是硅中介层,其曝光面积相当于掩模版的两倍。SoC(或ASIC)布置在中央,三个HBM分别放置在其左右两侧。
中间配置的曝光面积相当于硅中介层最大尺寸的掩模版的 1.5 倍。SoC布局在中央,左右两侧分别放置了两个HBM。
最小配置是硅中介层的最大尺寸,即相当于光罩1.3倍的曝光面积。两个 HBM 沿 SoC(或 ASIC)的侧面放置。
HBM2兼容“STAR 1.0”和HBM2E兼容“STAR 2.0”从最大配置到最小配置的标准规格相同。似乎他们有意识地在“STAR 2.0”中重用“STAR 1.0”的开发资源。
09 台积电先进制程和封装的更多细节
台积电院士兼副总裁 LC Lu 在之前的一个短短 26 分钟演讲内用数十张幻灯片谈到了实现系统创新。
台积电是全球排名第一的半导体代工企业,他们的开放式创新平台 (OIP) 活动很受欢迎,参加人数也很多,因为所提供的工艺技术和 IP 对许多半导体设计领域都非常有吸引力。台积电技术路线图显示了到 2025 年的 FinFET 和 Nanosheet 计划的时间表。

从 N3 开始,出现了一种名为FinFlex的新产品,它使用设计技术协同优化 (DTCO),有望为节能和高性能等细分市场改进功率、性能和面积 (PPA)。借助 FinFlex 方法,设计人员可以根据其设计目标从三种晶体管配置中进行选择:
3-2 fin blocks,用于高性能
2-2 fin,高效性能
2-1 fin,功率最低,密度最佳
工艺节点 N16 到 N3 中使用的fin选择的历史如下所示:

EDA 供应商 Synopsys、Cadence、Siemens EDA 和 ANSYS 已经更新了他们的工具以支持 FinFlex,并且在单个 SoC 中,您甚至可以混合使用fin block选项。沿着时序关键路径,您可以使用高fin单元,而非关键路径单元可以是低fin。作为进程缩放优势的示例,Lu 展示了一个 ARM Cortex-A72 CPU,在 N7 中实现,具有 2 个fin,N5 具有 2 个fin,最后是 N3E 具有 2-1 个fin:

N3E 的 IP 单元来自多家供应商:TSMC、Synopsys、Silicon Creations、Analog Bits、eMemory、Cadence、Alphawave、GUC、Credo。IP 准备状态分为三种状态:硅报告准备就绪、硅前设计套件准备就绪和开发中。
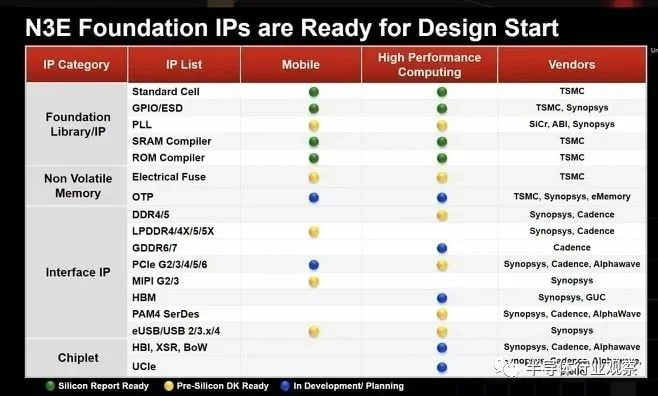
在 TSMC,他们的模拟 IP 使用结构化程度更高的规则布局,这会产生更高的产量,并让 EDA 工具自动化模拟流程以提高生产力。TSMC 模拟单元具有均匀的多晶硅和氧化物密度,有助于提高良率。他们的模拟迁移流程、自动晶体管大小调整和匹配驱动的布局布线支持使用 Cadence 和 Synopsys 工具实现设计流程自动化。
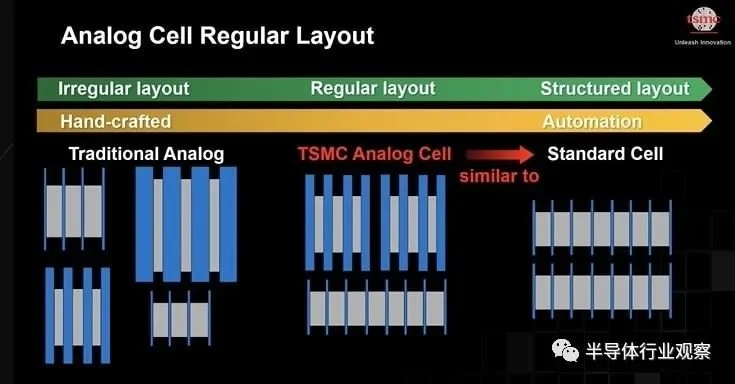
模拟单元可以通过以下步骤进行移植:原理图移植、电路优化、自动布局和自动布线。例如,使用他们的模拟迁移流程将 VCO 单元从 N4 迁移到 N3E 需要 20 天,而手动方法需要 50 天,快了大约 2.5 倍。
台积电需要考虑三种类型的封装,分别是二维封装(InFO_oS、InFO_PoP)2.5D封装(CoWoS)和3D封装(SoIC和InFO-3D)
3DFabric 中有八种包装选择:

最近使用 SoIC 封装的一个例子是 AMD EPYC 处理器,这是一种数据中心 CPU,它的互连密度比 2D 封装提高了 200 倍,比传统 3D 堆叠提高了 15 倍,CPU 性能提高了 50-80%。
3D IC 设计复杂性通过 3Dblox 解决,这是一种使用通用语言实现 EDA 工具互操作性的方法,涵盖物理架构和逻辑连接。四大 EDA 供应商(Synopsys、Cadence、Siemens、Ansys)通过完成一系列五个测试用例,为 3Dblox 方法准备了工具:CoWoS-S、InFO-3D、SoIC、CoWoS-L 1、CoWoS-L 2。
台积电通过与以下领域的供应商合作创建了 3DFabric 联盟:IP、EDA、设计中心联盟 (DCA)、云、价值链联盟 (VCA)、内存、OSAT、基板、测试。对于内存集成,台积电与美光、三星内存和 SK 海力士合作,以实现 CoWoS 和 HBM 集成。EDA测试厂商包括:Cadence、西门子EDA和Synopsys。IC测试供应商包括:Advantest和Teradyne。
AMD、AWS 和 NVIDIA 等半导体设计公司正在使用 3DFabric 联盟,随着 2D、2.5D 和 3D 封装的使用吸引了更多的产品创意,这个数字只会随着时间的推移而增加。台积电拥有世界一流的DTCO工程团队,国际竞争足以让他们不断创新新业务。数字、模拟和汽车细分市场将受益于台积电在 FinFlex 上宣布的技术路线图选择。3D 芯片设计得到 3DFabric 联盟中聚集的团队合作的支持。
【来源:半导体行业观察】
