7 月 3 日消息,韩媒 ETNews 近日报道称,三星电子 AVP 先进封装部门正在开发面向 AI 半导体芯片的新型“3.3D”先进封装技术,目标 2026 年二季度实现量产。
韩媒给出的概念图显示,这一 3.3D 封装技术整合了三星电子多项先进异构集成技术。
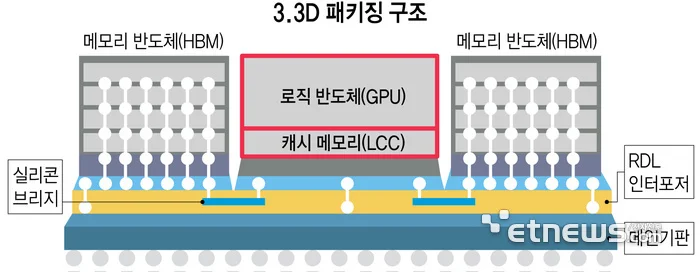
▲ 图源 ETNews
概念图中 GPU(AI 计算芯片)垂直堆叠在 LCC(IT之家注:即 SRAM 缓存)之上,两部分键合为一体,这点类似于三星电子现有 X-Cube 3D IC 封装技术。

▲ 三星 X-Cube 封装技术
而在 GPU+LCC 缓存整体与 HBM 内存的互联中,这一 3.3D 封装技术又与 I-CubeE 2.5 封装技术有不少相似之处:
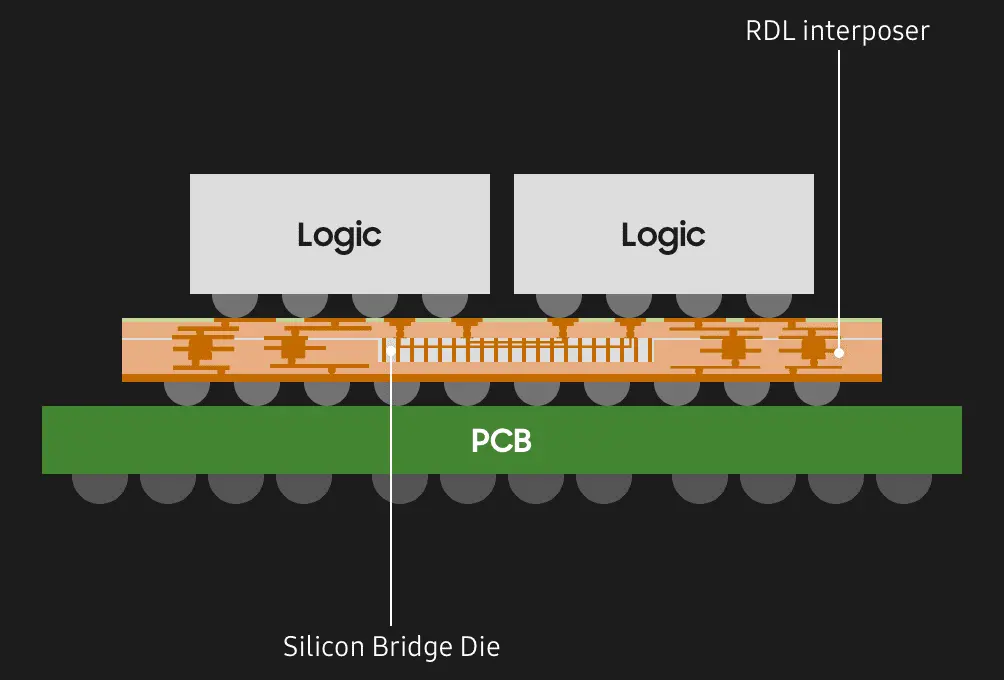
▲ 三星 I-CubeE 封装技术
GPU+LCC 缓存整体和 HBM 位于铜 RDL 重布线中介层上,用硅桥芯片实现裸晶之间的直接连接,而铜 RDL 重布线层又位于载板上方。
这一设计在大部分位置采用铜 RDL 重布线层代替价格可达前者十倍的硅中介层,仅在必要部分引入硅桥。
接近三星电子的消息源指出,该设计可在不牺牲芯片表现的前提下较完全采用硅中介层的方案降低 22% 生产成本。
此外三星电子还将在这一 3.3D 封装技术中引入面板级(PLP)封装,用大型方形载板替代面积有限的圆形晶圆,进一步提升封装生产效率。
韩媒认为,三星电子目标打造在价格和生产效率上均有显著优势的新一代 3.3D 封装技术,在目前由台积电主导的先进封装代工市场啃下更多无厂设计企业的订单。
【来源:IT之家】
